超高品質炭化珪素単結晶の開発
(株)豊田中央研究所
山口 聡、中村 大輔
郡司島 造、広瀬 美治
SiC(炭化珪素)半導体は、その良好な物理的・電気的性質(現在主流のSi半導体に比べ禁制帯幅3倍、絶縁破壊電界7倍、熱伝導率3倍)を持つため、次世代ハイパワー・超低損素子への応用が期待されています。従来、基板となるSiC単結晶ウエハは品質が十分とは言えず、大電力、高信頼性、低損失の素子製造を阻む大きな一因となっていました。これまで、SiC単結晶中に含まれる結晶欠陥*のうち、最もデバイス動作に悪影響を及ぼす中空貫通欠陥(マイクロパイプ欠陥)の低減が行われてきましたが、近年、マクロな結晶欠陥であるマイクロパイプ欠陥のみならず、より微細な結晶欠陥である転位欠陥等もデバイスの性能および信頼性等に悪影響を及ぼす場合があることが明らかになってきました。しかし、これまで転位欠陥等の微細な結晶欠陥を効率的に低減する手法はありませんでした。
今回、我々はマイクロパイプ欠陥のみならず微細な転位欠陥も除去する新規な手法である、RAF (ラフ)成長法(Repeated A-Face growth method)を開発しました。結晶中の転位欠陥の様子を調べてみるとa軸方向(c軸に垂直な方向)に成長した場合「転位欠陥は成長方向と平行な方向に伝播する」ということが分かり、これをヒントに考えたRAF成長法は、まず横方向(a軸方向)への成長を複数回繰り返した後に縦方向(c軸方向)へ成長させるというプロセスから構成されます(図1)。これまでは、一方向だけに成長させていた結晶を、横方向(a軸方向)→横方向(a軸方向)→縦方向(c軸方向)と90度ずつ方向を変えながら成長させることで、方向を変えるたびに効率的に結晶欠陥を少なくすることができるのではないかと考えました。
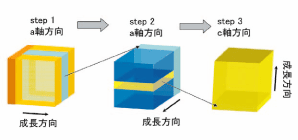
図1. RAF成長法の模式図
a軸方向(横)→a軸方向(横)→c軸方向(縦)と90度ずつ方向を変えながら成長させる。
このRAF成長法で作製されたRAF基板は本当に高品質(結晶欠陥が少ない状態)なのでしょうか?それを証明するため、SPring-8の放射光を使ったX線トポグラフィ*という実験方法を用いて観察しました。マイクロパイプ欠陥は肉眼(実体顕微鏡)でなんとか見ることはできますが、転位欠陥などの微細な結晶欠陥は肉眼では見ることはできません。見た目では鏡面にしか見えない単結晶ウエハもこの方法で観察すると、SiC単結晶を割ったり薬品にさらしたりすることなく、非破壊で微細な結晶欠陥も見ることができます。また、見ることができた微細な結晶欠陥は、どんなミクロな結晶欠陥なのでしょうか?これが分かれば、SiCデバイスの信頼性を上げる重要なヒントとなり得ます。
今回、二つの4H-SiC*ウエハを試料としました。一つは、RAF基板(直径2インチ、表面は(0001)面から8度オフした方向)で、もう一方は、比較のために従来の方法で作製した従来基板(直径1.2インチ、表面は(0001)面)です。肉眼ではどちらも鏡面状態で、結晶欠陥があるようには見えません。
実験は、SPring-8のBL20B2(医学・イメージング?)の第二ハッチで行いました。この実験ハッチは蓄積リングから200mも離れた位置にあるので、とても横幅が広く強度が一様な放射光を使うことができます。そのため一度に試料面全体に放射光を照射することができ、また単色の放射光であるため細かな結晶欠陥をとても鮮明に観察することができます。今回、X線を試料表面にすれすれで入射するようにし、表面にある結晶欠陥を観察する条件で実験を行いました(図2)。入射角が1度になるように、RAF基板の時は11.94keV、従来基板の時は9.86keVのX線をそれぞれ用いました。この実験では、表面からRAF基板の場合は約4μm、従来基板の場合は約2μmまでの深さにある結晶欠陥を観察することができます。トポグラフ・イメージは原子核乾板*に記録しました。

図2. BL20B2での実験光学系
光源から200mもの距離があり、横幅の広いきれいなX線を使用することができる。 X線を試料表面に対しすれすれの角度で入射することによって、結晶表面近傍に存在する結晶欠陥を観察することができる。
実験の結果、RAF基板には結晶欠陥が極めて少ないことが分かりました。図3にSiC基板のトポグラフを示します。図3(a)のRAF基板の場合では、結晶性はとても均質であり、またマイクロパイプ欠陥などのマクロな結晶欠陥、転位欠陥などのミクロな結晶欠陥も共に極めて少ないことが観察できました。それに対し図3(b)に示す従来基板では、マイクロパイプ欠陥や小傾角粒界などのマクロな結晶欠陥がたくさんあることが分かります。拡大すると、ミクロな結晶欠陥もたくさんあることが分かり、そのミクロな結晶欠陥には二種類あることが観察できました。一つはトポグラフではドット状に観察された結晶欠陥で、らせん転位と呼ばれる結晶欠陥であり、それはc軸方向にほぼ平行に存在する転位欠陥です。もう一方は底面転位(basal plane 転位)と呼ばれる転位欠陥対応し、トポグラフ中では白や黒の円弧として観察されます。この底面内転位は複雑に絡み合い、ネットワークを形成しています。従来基板ではこの底面内転位がたくさんありますが、RAF基板ではほとんどないことが分かりました。他の実験結果も合わせて、RAF成長法により製造されたSiC単結晶はマイクロパイプ欠陥や小傾角粒界が皆無であるばかりか、微細な結晶欠陥である転位欠陥が従来に比べ大幅に少なく( 転位密度で従来比1/100〜1/1000を達成)、結晶格子の歪みがほとんど無いことが分かりました。このように、どちらのSiC単結晶基板も肉眼では鏡面状態できれいな結晶のように見えますが、SPring-8でのトポグラフィ観察によってRAF基板はとてもきれいな単結晶であることが分かりました。
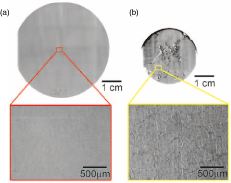
図3.
SiC単結晶基板のX線トポグラフ(a)RAF基板結晶欠陥が極めて少ない。拡大しても欠陥像は観察できない。(b)従来基板たくさんの結晶欠陥が観察される。ドット状の欠陥像はらせん転位、円弧状の欠陥像は底面内転位(basal plane)にそれぞれ対応している。
以上のようにRAF成長法によって製造されたSiC単結晶は非常に高品質かつ均質であることが、今回の放射光を用いたトポグラフィ実験で明らかにすることができました。このような高品質なSiC単結晶が製造できるようになったことにより、信頼性の高い大電力用チップの製造が可能になると考えられます。特に、大容量電力変換装置などのハイパワー用途において大幅な低損失化、機器サイズダウン、およびコストダウンが期待できます。
本研究の成果は、英国の科学雑誌「Nature」の2004年8月26日号に掲載されました。
用語解説
●結晶欠陥
理想的な結晶内の原子・分子は規則正しく配列するが、実際の結晶では配列の乱れが存在する。その結晶格子の構造上の乱れのことをいう。
●X線トポグラフィ
X線の回折現象を用いて、非破壊で単結晶中の結晶欠陥を可視化する実験手法の一つ。結晶欠陥の周りの歪みを検出し、様々な条件でトポグラフを撮ることにより、結晶欠陥の詳細な情報が得られる。
●4H-SiC
化学組成が同じであるが結晶構造が異なる(ある一方向の周期構造が異なる)場合があり、これを結晶多形という。SiCでは非常に多くの多形が存在し、その中で主なものは六方晶の4H、6H及び立方晶の3Cの3種類である。異なる多形では物性値も異なり、パワーデバイス用としては比較的キャリア移動度の高い4Hが注目されている。
●原子核乾板
特殊な写真フィルムの一種。ガラス板上に光や荷電粒子に感光する乳剤が塗布されたもので、数μmの非常に高い空間分解能を持つ。元々は素粒子・原子核・宇宙線の実験に用いられているものである。